等离子增强化学气相沉积操作方法
来源:网络收集 点击: 时间:2024-03-28所用材料:SiH4、N2、N2O、NH3、CF4/O2等,具体需要根据工艺设置参数。
开机
打开技术夹道里面的干泵冷却水(先开回水、再开进水,水压调整在1.5Kgf左右)、打开干泵边上的氮气阀(吹扫干泵)、配气柜边上的压缩空气(CDA)阀门,再打开需要使用的工艺气体。
打开设备后面的冷却水、CDA、N2等阀门,然后打开设备电源、打开设备的计算机。
设备计算机打开后,直接打开设备控制软件,登录进入控制界面。
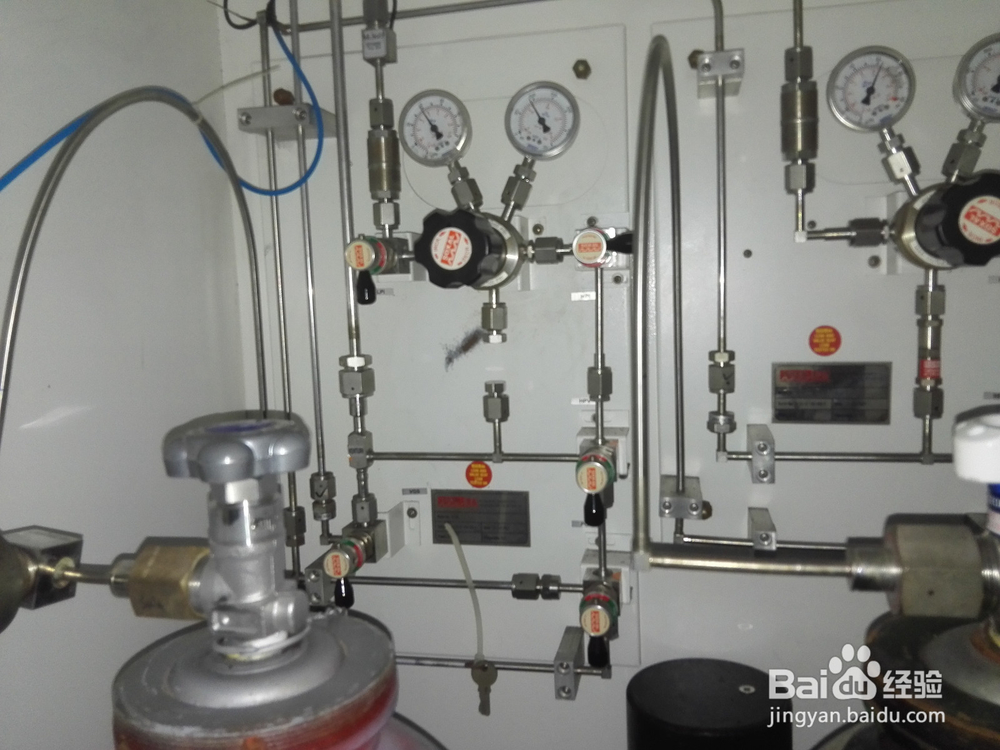 2/6
2/6进入Process--Chamber,设置温度为300℃,点Start按钮▶,等待温度升到300℃。
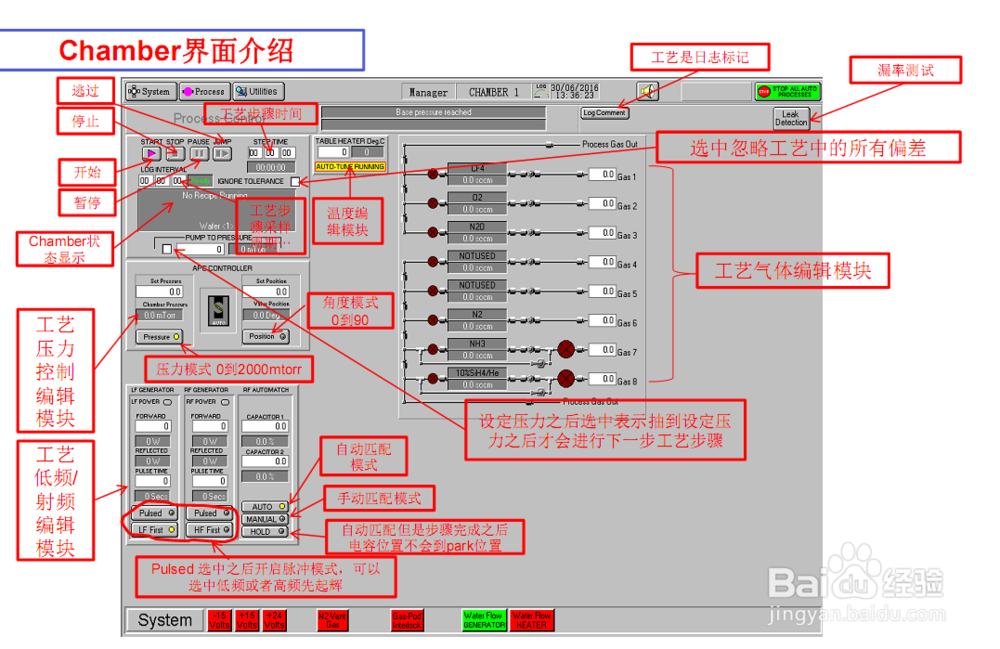 3/6
3/6点击System -- Pumping,点击下面的“Stop”,再点击“Vent”,开始对腔体充气,当腔体内压力等于外界压力时,双手按住机台上两个“Hoist”按钮打开盖子。
确定把需要生长氮化硅或氧化硅薄膜的样品放置在底盘的中心位置,四周用小硅片围住,以免在工艺过程中被气流吹跑。
样品放置好后,点击其下方的“Stop”,再点击“Evacuate”, 会出现一个对话框让输入备注信息,此时可以输入生长的材料及姓名等信息以便以后查询,输入完成后直接回车确认,开始抽真空。当腔压抽到2mTorr时,就可以进行实验了。
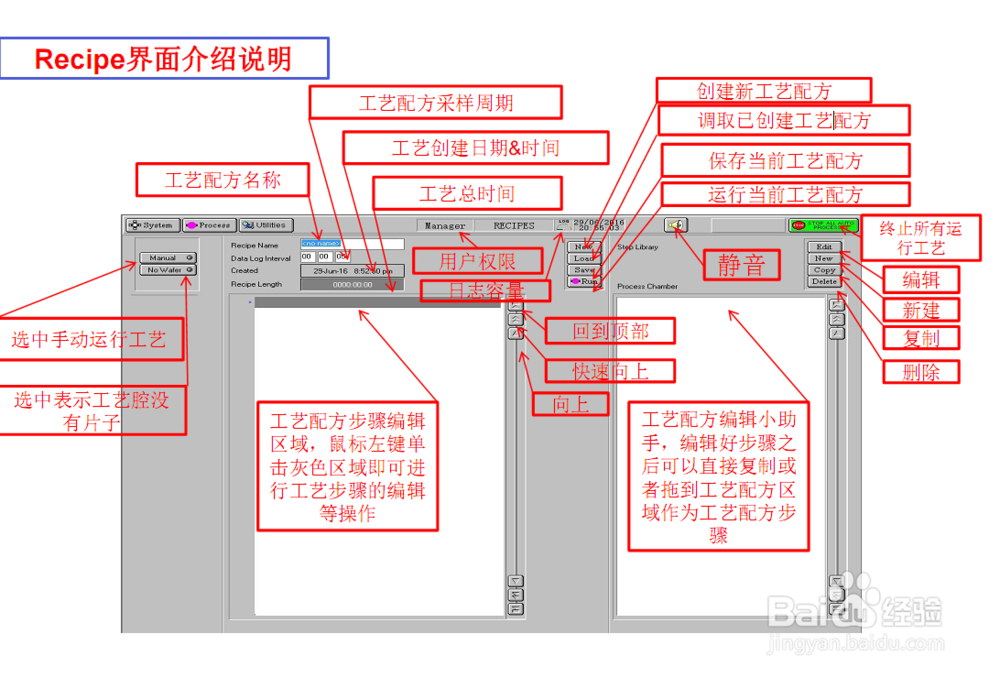 4/6
4/6确定真空度已达到2mTorr以下,无其他警报,再次确认工艺气体、尾气处理、水洗塔状态。
选择运行程序:当反应腔达到基础真空后,点击Process--Recipes--Load选择相应程序(若是需要更改程序参数,可以直接选择一个程序后,点选程序里面的各步骤进行程序的编辑),并点击OK,程序运行前需仔细检查各工艺参数,确认无误后点击“Run”,运行程序。
工艺结束后,会弹出一个提示窗口,说明程序已经完成,点击“OK”,程序自动进入“Pumping”模式。

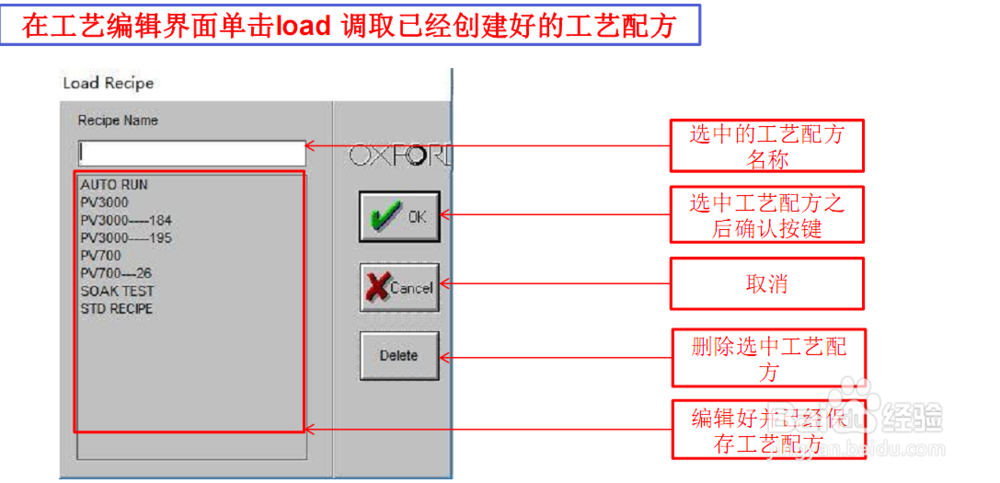
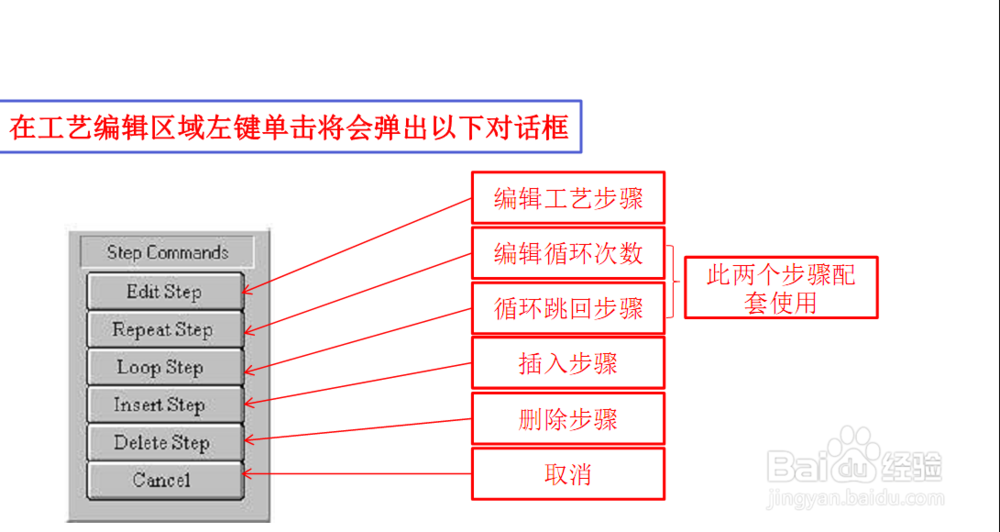
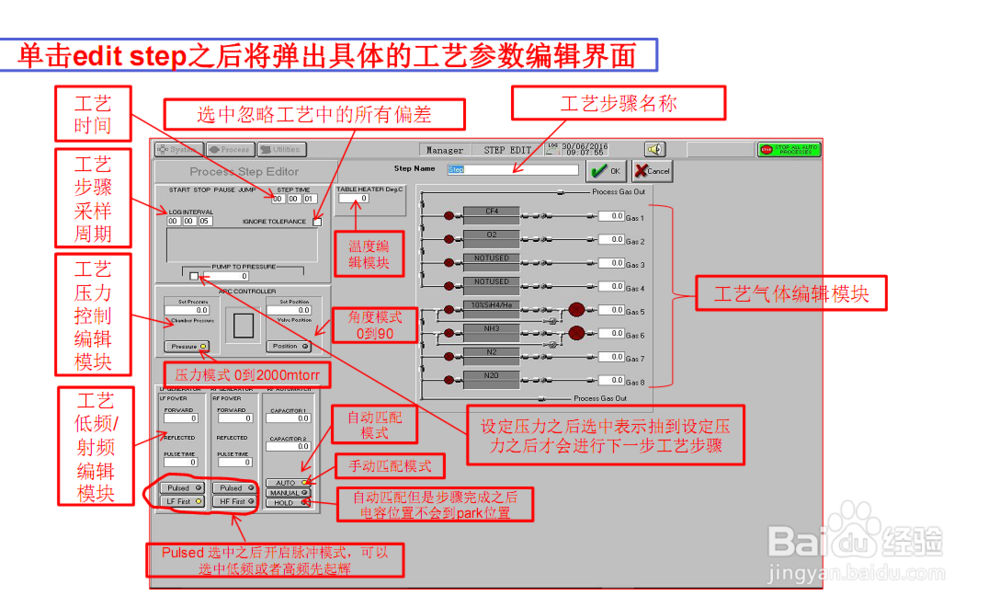 5/6
5/6工艺完成后,点击控制面板中的“Stop”按钮,再点击 “Vent”按钮,开始对腔体充气,当腔内为大气压时,同时按住两个“Hoist”蓝色按钮,打开盖子,设备会自动关闭充气阀,或者等到其充气时间到达设备自动关闭充气阀;取出制品。
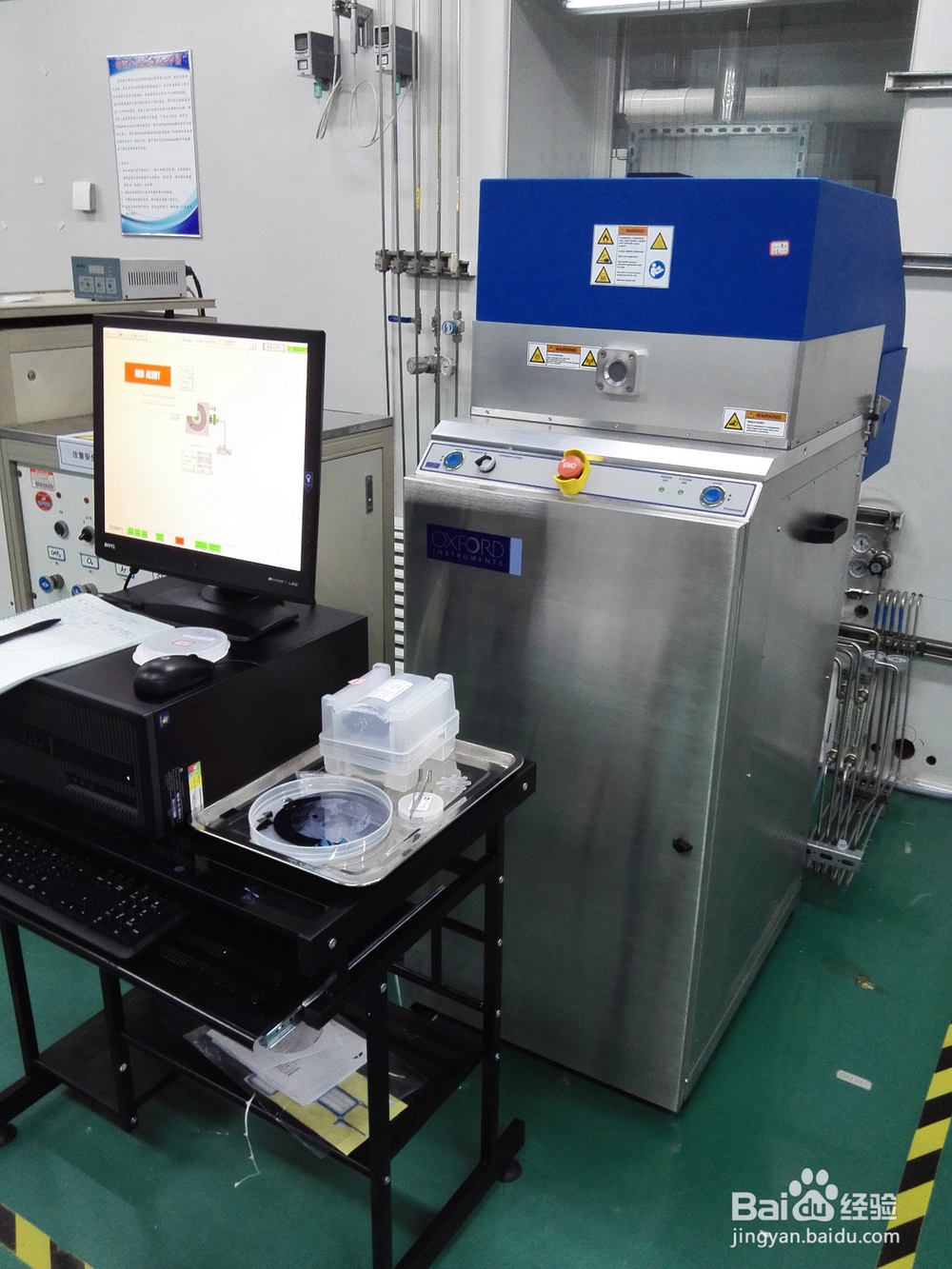 6/6
6/6关机时要将腔内抽为真空,然后将机械泵关闭;之后再退出程序,关闭电脑,电源,水电气等。
清洁腔体
每次更换不同生长材料时,都要打开腔体手动清洁腔体,清洁后使用clean程序用O2和CF4清洁一次腔体,然后使用Dry clean刻蚀程序根据前面生长样品的厚度设定刻蚀时间,一般生长多长时间,就要刻蚀多长时间。
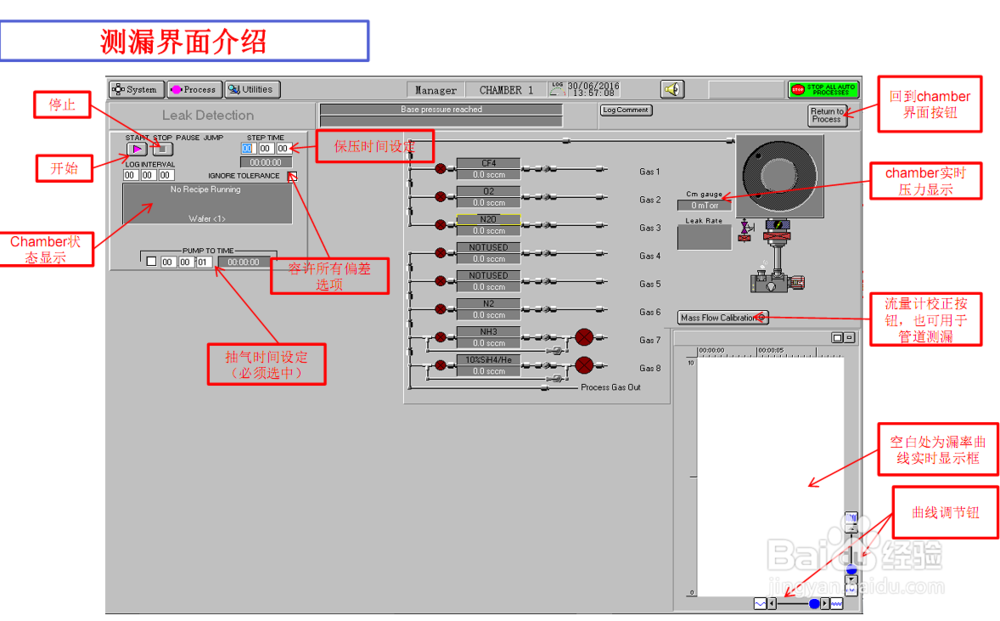 注意事项
注意事项更换材料时,必须生长500nm的环境,以避免交叉污染。
每次放样品的时候,一定要注意安全,避免使用塑料镊子,以免融化。
手套、袖口一定要收紧,避免身体任何部位接触到托盘,小心烫伤。
版权声明:
1、本文系转载,版权归原作者所有,旨在传递信息,不代表看本站的观点和立场。
2、本站仅提供信息发布平台,不承担相关法律责任。
3、若侵犯您的版权或隐私,请联系本站管理员删除。
4、文章链接:http://www.1haoku.cn/art_369781.html
 订阅
订阅